由于标准测量技术的局限,测量滤光片,尤其是有陡峭的和陡边缘的滤光片,的光谱特性时往往得不到精确的结果。因为光学滤光片的实际阻挡值不仅仅由它的设计光谱决定,也由滤光片的物理缺陷例如在滤光片镀膜过程中由于污染、表面缺陷或者镀膜工艺产生的针孔所决定。一般测量滤光片的传输和OD性能是用的市售的分光光度计。当光学滤光片具有高边缘陡度和/或非常深的阻塞时,这些仪器的测量就具有很大的局限性。
由于这些限制,滤光片的实际光谱和测得的光谱曲线之间存在三个主要的差异。第一个差异是锋利的光谱特征的“四舍五入”,这来自于分光光度计探测光束的非零带宽。第二个差异源于分光光度计的灵敏度。第三个差异源于从高阻塞到高传输的过渡测量唯一一种器件,它被称为“边带测量工件。”此工件源于非单色探测光束,在带宽之外还具有弱边带,由此带来了误差。
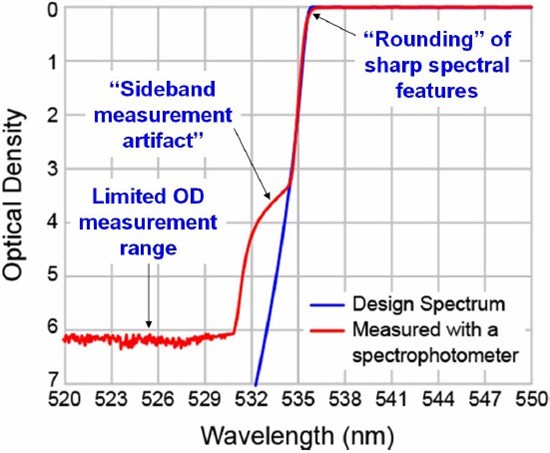
图1
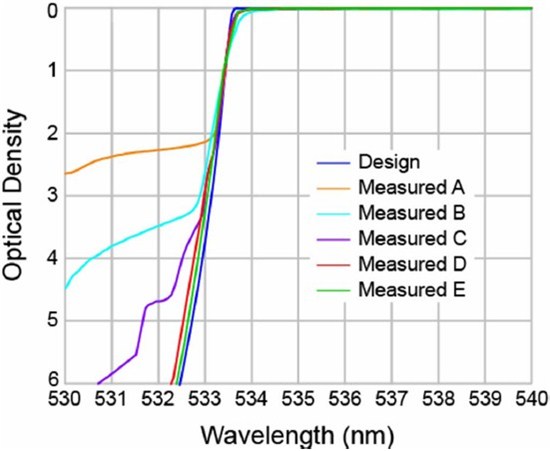
图2
Semrock采用不同的计量方法来评估过滤光谱。图2示出了同一个E级RazorEdge®滤光片五个不同的的陡边缘测量结果,该滤光片在532nm有OD> 6的阻止和和在0.5%的激光波长内变化到高传输(534.7 nm)。测定光谱符合滤光片(蓝线)的设计光谱。如图所示,选择的不同的测量仪器和技术会极大地影响我们测得的滤光片光谱曲线。A线是从一个定制的分光光度计得到的。本仪器的一些特性 - 例如短积分时间和较低的分辨率 - 是为镀膜过程中大量的滤光片的快速数据收集专门进行优化过的。然而,这种方法的灵敏度和分辨率较差。B采用的是标准的商用分光光度计(珀金埃尔默LAMBDA 900系列)。实际的滤光片光谱特性和测得的光谱之间的差异显而易见。C和D都是用A中定制的分光光度计的改良版,基本原理如图3所示。仪器采用低噪声CMOS摄像头(即探测器阵列),能够同时测量很大范围的波段。C的改进使用旨在增强对于滤光片陡峭和深边缘的测量(主要通过积分时间和分辨率)。然而,“边带测量工件”仍是显而易见的制约因素。D除去了方案C里的这个工件。E 通过仔细过滤532nm的激光和角度调谐显示出了与滤光片本身性质非常符合的测量结果。测试中取得的发射与角度数据用理论模型被转换成透过与波长的结果。显然,E最接近实际的光谱曲线;但它很难推广到大批量的测量中。
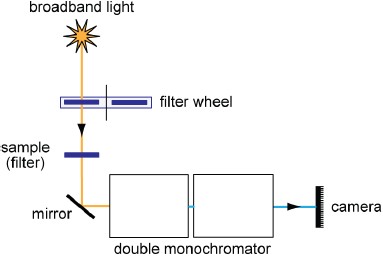
图3
总之,要理解用于滤光片的光谱曲线测量技术并不完美。使用一个给定的滤光片或应用合适的测量方法,可以减少对于滤光片系统或者实验的过度设计与错误,从而优化性能,提高实验效果,甚至减少滤光片的成本。
有关此主题的更多信息,请访问我们的网站:
www.semrock.com